BEOL of the Front-end

BEOL of the Front-end
With geometries getting smaller, inspection becomes both more challenging and crucial for defect-free and high-yield wafer manufacturing. The variety of defects at the Back-end-of-Line (BEOL) of the Front-end calls for detection optimization, fast screening and categorization of the high volume manufacturing environment, while maintaining high throughput.
BEOL of the Front-end inspection challenges vary from one process step to another, and include:
- In the lithography process step, defects of interest include: Defocus, bad coatings, blocked contacts, bridging, missing or extra patterns and critical dimension variation;
- In the etch process step, defects of interest include: Particles, pinholes, peeling, residues, water marks, scratches and corrosion;
- In the chemical mechanical polishing (CMP) process steps, defects of interest include: Scratch detection, residue detection, unpolished/insufficiently polished areas and brush marks;
- In the outgoing quality control (OQC) process step, defects of interest include: particles, pinholes, peeling, residues, water marks, scratches and corrosion.
Camtek’s Eagle platform can handle all these challenges and detect typical defects of interest at high volume manufacturing environment.
Capabilities
- Full coverage inspection providing zero PPM to the most advanced technology nodes
- Enhanced 2D detection algorithm with color variation robustness
- Sub-pixel alignment mechanism
- Backside inspection, including: Modular backside unit, detection of macro cracks, scratch, contamination and wafer chippings.
- High throughput at high-volume manufacturing rate
- Combined dark and bright field illumination
- Capability to merge front side inspection and back side inspection results
- Creating recipes offline maximizing tool utilization
- Analytic tools, including Advanced Defect Classification (ADC) and yield management system
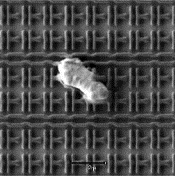


Products





